在進行TEM/EDS成分分析時,特別是涉及碳、氮、氧等輕元素時,低能量X光被吸收的效應仍然相當明顯,而且被吸收的量會隨著試片厚度的變化而改變。必須藉由某些特殊的校正技術,才能重新拉回準確度。
隨著半導體技術的不斷演進,奈米區域成分分析在新製程開發中的重要性日益突顯。透過透射電子顯微鏡/能量分散光譜(TEM/EDS)技術,研究人員能夠深入鑑定奈米區域的成分資訊。然而,在進行TEM/EDS成分分析時,特別是涉及碳、氮、氧等輕元素時,低能量X光被吸收的效應仍然相當明顯,而且被吸收的量會隨著試片厚度的變化而改變。
非常恰巧的是,這些輕元素的化合物都是製造半導體元件常用的材料。因此,用TEM/EDS做半導體元件成分定量分析時,如果有碳、氮、氧等任何元素牽涉在內時,不準度將會提升,必須藉由某些特殊的校正技術,才能重新拉回準確度。
EDS成分分析
EDS成分分析儀可架設於TEM和SEM兩種電子顯微鏡上,本文探討的成分分析技術專注在TEM/EDS中。做EDS成分分析的人都知道在SEM/EDS系統中,輕元素的X光吸收效應非常顯著,所以定量成分分析時,必須使用ZAF法修正。Z指原子序數(Atomic Number),A指吸收(Absorption),F指螢光性(Fluorescence)。
也就是說在SEM/EDS中,吸收效應非常顯著。相對於SEM使用塊材當樣品,TEM使用薄片(Thin Foil)型試片。因此很多人認為在TEM/EDS分析中,吸收效應可忽略。在很多材料系統,例如金屬材材料,即可忽略吸收效應。
但是從數以百計的TEM/EDS分析案例中,可以發現特別是碳、氮、氧等這些常見於半導體元件中的輕元素,所產生的低能量X光被吸收的效應不但相當顯著,而且被吸收的量還會隨著試片厚度改變。導致運用TEM/EDS做半導體元件成分定量分析時,如果牽涉到碳、氮、氧等輕元素在內時,材料組成分析結果將失準,這對於半導體新製程開發,是相當不利的。
圖1顯示二組含氮化物和氧化物的TEM/EDS能譜。圖1(a)分析區域包含氮化鈦(TiN)和二氧化矽(SiO2)二相(如右上角TEM影像的橘色圓圈標示),是半導體元件的基本結構的部分。圖1(b)分析區域為氮化鎵(GaN)層(如右上角TEM影像的橘色圓圈標示)。SiO2、TiN、和GaN都是定組成化合物(Stoichiometric Compounds),二氧化矽中原子數比二個氧原子對一個矽原子,二個氮化物都是一個氮原子對一個金屬原子。

圖1 含有N、O輕元素化合物的TEM/EDS能譜。(a) SiO2 + TiN;(b) GaN (圖片來源:宜特科技)
理論上,訊號強度和組成元素的濃度成正比,所以氧能峰應該是矽能峰的兩倍高,氮能峰應該和鈦或鎵的能峰一樣高。但是在實際的EDS能譜中,氮和氧的能峰都低很多,如圖1中二個能譜所示。造成這種結果的機構主要有二,是本文接下來要討論的主題。
EDS偵測器靈敏度曲線
首先,EDS偵測器本身特性,對各能量的X光的偵測靈敏度並不相同。從0~30 KeV的EDS偵測器靈敏度曲線如圖2(a)所示[1],在3.0~19.0 KeV之間偵測靈敏度為1。低於3.0 KeV的低能量區,EDS偵測器的偵測靈敏度,隨能量降低迅速下降至零。
圖2(b)是低能量區域的放大圖[1],在高於19.0 KeV的高能量區域,EDS偵測器的偵測靈敏度也會隨能量增加而緩緩下降。偵測靈敏度降低的機構在低能量區和高能量區不同,當X光的能量過高時,會直接穿透偵測晶體而沒有產生電子─電洞對,導致偵測靈敏度下降;偵測靈敏度在低能量區下降的機構則是源自偵測器元件結構的衰減。
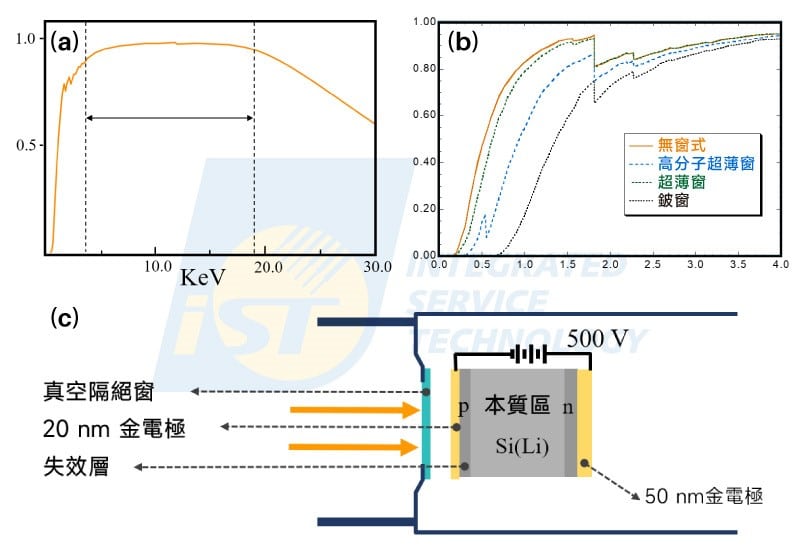
圖2 EDS偵測器。(a)靈敏度曲線圖;(b) 靈敏度曲線圖低能量區域放大圖;(c) 偵測器簡易結構剖面示意圖(ref. [1] & [2]) (圖片來源:宜特科技)
在偵測晶體前緣有三層結構會衰減低能量的X光,X光能量愈低,被衰減的量愈多,最後被完全阻絕進入偵測晶體。此三層結構分別為真空隔絕窗、金電極、失效層(Dead Layer),標示在圖2(c)的偵測器簡易結構剖面示意圖內。
這三層結構中,最主要的衰減層是真空隔絕窗。最早期的真空隔絕窗材料使用厚度7~12微米的金屬鈹(Be),此種EDS偵測器很耐用,但是無法偵測氧(含)以下的元素,改良成高分子超薄窗後,EDS可以偵測到碳,用無窗式的EDS偵測器則可偵測到硼(B)。雖然2010年後,EDS偵測器的效能和性能有大幅度的提升,也逐漸用矽漂移偵測器(Silicon Drift Detector, SDD)取代鋰漂移偵測器(Lithium-drifted Silicon Detector, Si(Li)D),再搭配無窗模式,對氧的靈敏度提高2.5倍以上[3]。但是在低能量區偵測靈敏度迅速下滑的趨勢,仍然維持不變。
EDS能譜最後呈現的元素能峰高度,是所有進入EDS偵測器的X光,和EDS偵測器的靈敏度曲線卷積(Convolution)的結果。圖3簡易說明卷積運算的概念,圖3(a)中藍色虛線的能峰代表理想狀態下氧化鋁(Al2O3),被電子束激發後產生的X光的強度,氧能峰的高度是鋁能峰的高度的1.5倍,橘色曲線是EDS靈敏度曲線。二者卷積後形成圖3(b)中的實際EDS能譜,氧能峰高度不到鋁能峰高度的一半。

圖3 氧化鋁的EDS能譜示意圖(a)和實際EDS能譜圖(b) (圖片來源:宜特科技)
因此定量分析推算二者的真正濃度時,必須先用元素的能峰強度(Peak Intensity)或能峰積分強度(Integrated Intensity),除以該元素的靈敏係數。由於氧的靈敏係數遠小於1,所以些微的氧訊號強度變化,就會導致數據顯著的波動,增大運算結果的不準度。