逆向工程(Reverse Engineering)對於不熟悉此工程的人,常常將之與駭客、盜版、竊盜連結在一起。但其實不盡然,隨著專利戰盛行,逆向工程對於許多企業而言,不僅是用來保護自身的專利,確保競爭對手不能非法使用這些專利,同時也保護自己不會侵犯到競爭對手的專利。
而對於半導體產業而言,逆向工程更一直是研發設計的主軸,可以協助IC設計在開發新產品所需的成本、工時、人力與技術作全面性的分析,並可針對有專利性的電路,經專利地圖資料庫分析比較以做好專利迴避,藉此了解市場態勢並掌握商機。
本文將從兩方面切入,一、奈米等級的先進製程晶片,如何透過去層手法(Delayer),取裸晶(Die)觀察裡頭每一層的電路布局(Layout);二、BGA封裝體、PCB等級的大範圍Layout提取逆向分析技術。
奈米等級先進製程晶片逆向分析
隨著摩爾定律發展,製程演進至7奈米、5奈米甚至3奈米,晶片裏頭的裸晶,幾乎是接近螞蟻眼睛大小,一般人眼無法辨識。因此,希望藉由一般的晶片去層來完整提取裸晶裏頭每一層的電路,難度非常高,硬是進行一般層次去除技術的後果,不只是良率偏低,更可能發生連裸晶都去除到不見遺失的窘境。
不過,為了做專利迴避、或是需完整呈現該層電路圖找Defect時,還有什麼方式可以完整提出電路圖呢?
以往一般的取裸晶後去層的技術,會因為樣品過小等因素,導致裸晶不見或破裂而無法進行製程分析;當無法去層到金屬層(Metal)M1時,記憶體(Memory Block)僅能以推測得知,電路模組分析圖亦無法完整繪製。
驗證分析實驗室宜特的去層技術,利用三步驟(圖1),可將樣品如魔術般放大,直接在晶片封裝(Package)還存在的情況下進行去層工程,不僅可以提升工程上的良率,完整提出電路圖,還可衍生應用在合金銲墊(Pad)、精密晶片及其他無法取裸晶卻需要去層的晶片樣品上。

圖1 三步驟晶片去層技術,完整提出電路圖
三步驟完整提出電路圖
步驟一樣品製備物理方式去膠體
首先,在晶片封裝還存在的情況下,以物理方式去除晶片裸晶正面多餘的膠體。相較以往須先去除封裝僅在裸晶上去層,此法可在較大的面積/體積上施作,可大幅減少後續去層時裸晶遺失的機率,並保持裸晶面的平整度(圖2)。

圖2 第一步驟先透過物理方式去膠,提出最上層電路圖
步驟二機台去層
再來,藉由離子蝕刻機,將IC護層(Passivation)與隔絕層(Oxide),用適當參數以離子蝕刻方式,將不需要的部份移除,藉由宜特的控制參數方式,使得下層金屬層不受傷(圖3)。

圖3 第二步驟,透過電漿離子方式,進行去護層
步驟三藥液去層
IC護層(Passivation)被去除後,再以藥水蝕刻,蝕刻該層需去除的金屬層,即可完整提出電路圖。

圖4 去完護層後,透過化學藥液浸泡,再次去除金屬層,提出底層電路圖
BGA封裝體/PCB等級 逆向分析技術
如欲了解BGA封裝體各層結構,在這種情況下,是無法使用破壞性酸蝕手法進行封裝體去除,一旦去除,BGA封裝體就會遭受破壞。那該怎麼辦呢?此時,可以透過超高解析度3D X-Ray顯微鏡,此為非破壞性的X射線透視技術,搭配光學物鏡提高放大倍率進行分析,分析手法為將待測樣品固定後進行360°旋轉,在這過程中收集各個不同角度的2D穿透影像,之後利用電腦運算重構出待測樣品之實體影像。
特別是,可以針對待測樣品進行各層分析,讓內部結構逐一顯現,如圖5所示,針對BGA待測樣品,從封裝體至晶片內各層走線都能逐一提出;透過影像呈現,還可以測量局部線寬/線距,導通孔(Via)尺寸與各層結構的厚度。

圖5 使用高階3D X-ray掃描BGA基板各層之影像
對於SiP、小型BGA等封裝體,只要待測樣品尺寸在5×5mm以下且觀測層在三層以內,可以選擇不破壞樣品方式以3D X-ray進行逆向分析;但若待測樣品是大型BGA複雜封裝體,尺寸超過5×5mm以上,就建議必須進行晶背研磨(Grinding)去層動作,接著透過數位光學顯微鏡(OM)進行拍照,藉此更清楚呈現走線樣貌(圖6)。

圖6 透過一般研磨(Grinding)與OM拍照之BGA載板各層影像
若希望能夠逆向分析BGA中基板層走線,也期待可以得知封裝內晶粒金屬層的布局分析,甚至能夠將基板與金屬布局分析圖進行疊圖透視,那是否可以先用3D X-ray拍Substrate Layer 1~3層,再研磨將Substrate去層,透過OM拍攝金屬層,得到兩種影像後,進行Substrate Layer 1~3層+Metal層上下疊圖透視?
答案是不行的。因3D X-ray和OM屬於兩種不同的影像呈現,絕對無法疊圖透視,且從錫球面進行研磨,而非從晶背面或IC正面端拍照,拍照與疊圖順序會是鏡向狀態,較不好判讀,如(圖7)左。
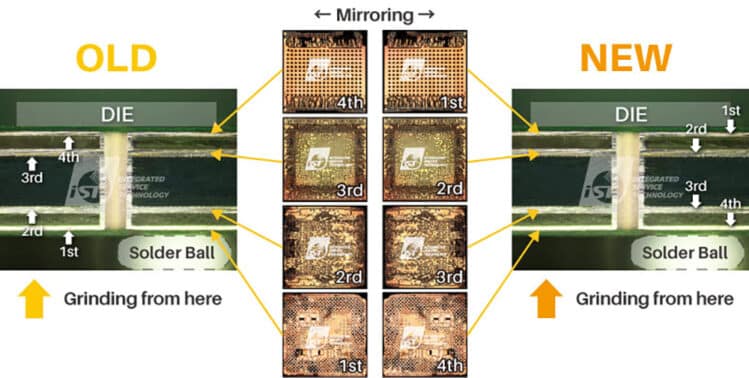
圖7 (左)從錫球面進行研磨,而非從IC正面端拍照,拍照與疊圖順序會是鏡向狀態,較不好判讀;圖7(右)透過宜特提供的看圖軟體,能夠將各層照片大翻轉,並且從上至下疊圖
有廠商如宜特故障分析實驗室,開發特殊逆向分析手法,可快速協助獲得Substrate Layer 1~3層及金屬層堆疊透視影像圖,並透過宜特提供的看圖軟體,能夠將各層照片大翻轉,並且從上至下疊圖(圖7)右,方便使用者追線,得知各層連接關係(圖8)。
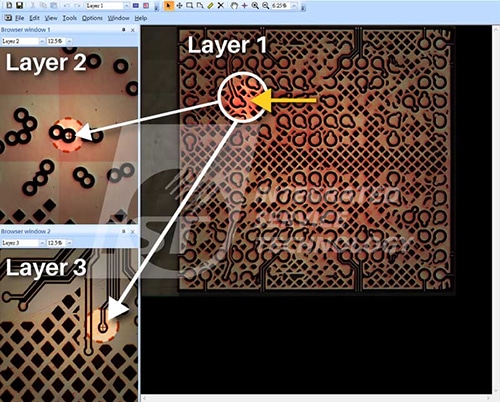
圖8 看圖軟體方便使用者追線,得知各層連接關係
(本文作者皆任職宜特科技,張舒雯、彭文賢、蘇振忠為技術副理、盧芮茵為課長)